NAND Flash Memory Application测试介绍
NAND 闪存是现在数字生活的核心技术,使各种必不可少的设备和技术得以实现。从智能手机、平板电脑、汽车应用领域中使用的eMMC和UFS,到笔记本电脑、服务器、数据中心的高性能SSD存储,NAND闪存确保了数据无缝存储与访问。凭借其自身紧凑的尺寸、高速、可靠性,NAND闪存从个人电子设备到企业基础设施的多层面推动创新。
基于NAND闪存的产品如 Raw NAND, eMMC, UFS, SSD必须确保数据完整性与产品长期稳定性。 QRT的 "NAND Product Testing Solution(NAND产品测试解决方案)"从 Raw NAND到应用产品,提供关键性指标以确认设计和制造质量,确保产品在多元化的环境和使用条件下维持预期性能。

| 区分 | Raw NAND | eMMC / UFS | SSD (Solid State Drive) | ||||||||||||||
|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|
| 主要用途 | 嵌入式、工业系统等需要单独设计和应用控制器的定制环境 | 移动设备 (智能手机、平板电脑)、汽车电子、 IoT(物联网)等小型·低功耗·高可靠性需求环境 | PC、笔记本电脑,、服务器、数据中心等大规模·高性能存储需求环境 | ||||||||||||||
| 有无控制器 | 无 (Host/依附于外部控制器) | 内置控制器(自动执行ECC, Wear-Leveling, Bad Block管理等) | 搭载高性能控制器 (支持大容量DRAM缓存、 高级错误校正、断电保护功能等) | ||||||||||||||
| 性能要求 | Cell Level读/写入准确性、稳定性、 基本物理特性 | 快速启动/响应速度, 移动·嵌入式最优化 (低功耗·低发热),具备中等水平的读/写入性能 | 连续读·写入, 随机 Random IOPS, 低延迟等高性能指标,支持服务器·企业环境中的大规模并发访问 | ||||||||||||||
| 寿命·耐久性指标 | P/E 循环限制(P/E Cycle Limit)、单元老化分布(Cell Degradation Distribution )、依存于主机固件的磨损均衡(Host Firmware-Dependent Wear-Leveling) | 产品自身定义的写入/擦除限度,基于内置控制器的寿命管理 (错误Block自动管理, Wear-Leveling) | 总写入数据量TBW(Total Bytes Written)、 磁盘每天写入量DWPD(Drive Writes Per Day)等衡量的大容量、长时间写入耐久性,在企业级中,备用Block管理和断电保护等尤为重要 | ||||||||||||||
| Error校正 (ECC)方式 | 外部控制器或Host实现ECC | 内置控制器执行ECC功能,用户无语额外实现 | 高级ECC引擎及额外的数据保护机制 (断电保护、 RAID级别冗余等) | ||||||||||||||
| 发热·功耗管理 | NAND封装本身发热不大,但外部控制器的功耗和发热设计至关重要 | 搭载于小型设备的发热·功耗管理受限,但结构上采用较佳的功耗低控制器设计 | 可适用于台式机/服务器环境中散热片·冷却系统,需考虑高性能运行时发热增加与热节流(Thermal Throttling) | ||||||||||||||
Non-Volatile Memory (Raw NAND) Testing
非易失性储存器的耐久性和保持性试验(Non-Volatile Memory Endurance & Retention test)由以下两部分组成 1) 耐久性试验(Endurance Test,即写入/擦除反复试验)和 2) 数据保持性试验(Data Retention Test,数据保持性试验)。在耐久性试验中,按规定的次数写入和擦除后,一旦判定为 "Pass"。则将全部样品一分为二进行保持性试验(Retention test)。耐久性试验(Endurance Test)中,需要由设计者(或可靠性负责人)直接指定写入的模式( pattern)和写入/擦除的试验部分。保持性试验(Retention Test)根据标准的不同有些许差异, JEDEC标准使用高温贮存试验(HTSL)和 低温工作寿命试验(LTOL),而 AEC标准中使用 高温工作寿命试验(HTOL)和 高温贮存试验(HTSL)。
JEDEC_JESD47K
Additional Qualification Tests for Non-volatile Memory Device

AEC_AEC-Q100-005
High Temperature Test Sequence for Devices Containing NVM

QRT的专用储存类老化试验设备通过高速测试能力和实际使用环境模拟,确保储存类半导体的可靠性和质量。在高温条件下,设备能够早期检出初期不良器件,从而提高产品的可靠性。此外,该设备可同时测试多颗存储类器件,在大批量生产环境中实现高效的质量管理和成本节减。

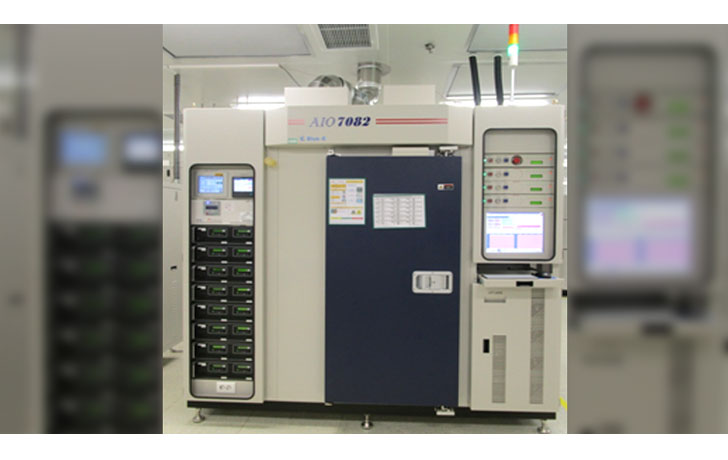
- 上一个:
- 下一个:Managed NAND Tesing :eMMC,UFS






