稳态温湿度偏置/无偏置寿命测试(THB/THS)测试介绍
高温高湿偏压测试
高温高湿环境的可靠性评估、半导体内部金属要素的腐蚀、迁移(Migration)耐性评估
测试介绍
封装形态不同,水分渗透及渗透水分的影响等呈现出的特性不同。通孔(Through-hole)形态较厚的封装比起厚度较薄的SMD封装,每单位体积吸收水分的速度更慢。Package是随着水分渗透和停留而产生的问题,突然暴露在高温(如:实装工序)中,形成水蒸气,Package内部产生较大应力的现象。由水分产生的package crack被称为popcorn cracking。一般来说,表面贴装型产品(SMD)具有以下因素,popcorn cracking的概率更高。
适用技术
电子产品暴露的最常见的环境是在高温、潮湿的环境中工作的状态。半导体内部的金属因素如果密封不好,可能会发生腐蚀或迁移,因此可以通过THB试验评估不良机制的耐性
DATA EXAMPLE
在THB 试验中发生的不良机制
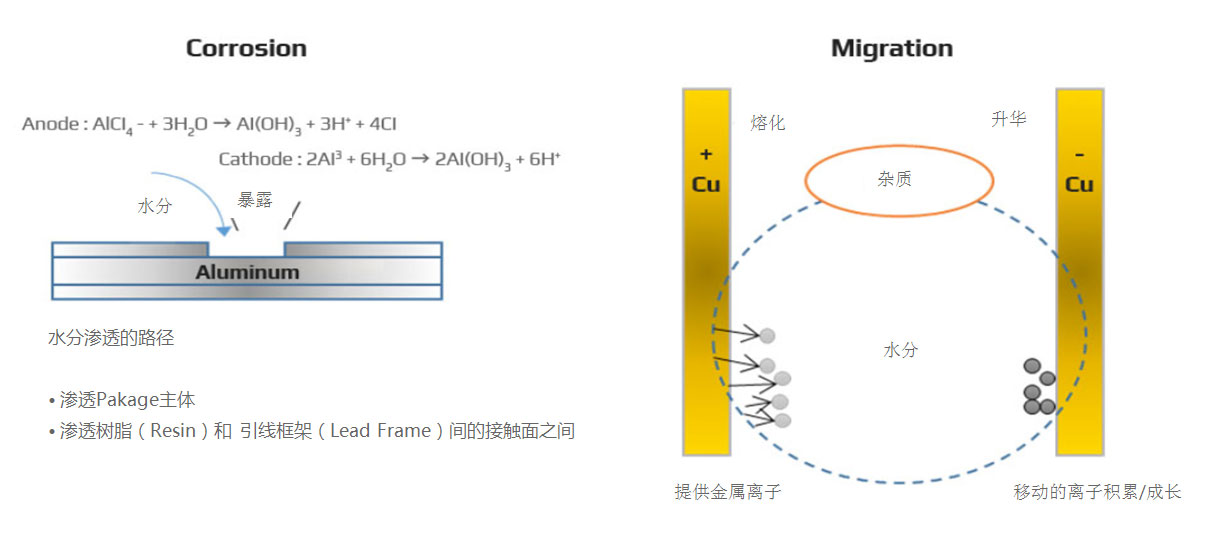
| 参考规范 | |
|---|---|
| 稳态温湿度偏置寿命测试 THB | |
| JESD22-A101D.01:2021 | AEC-Q100-REV-J:2023;Table 2,Test group A2,THB |
| AEC-Q104-Rev:2017;Table 1,Test group A2,THB | AEC-Q200-Rev-E:2023;Table 6 No.7 Humidity Bias |
| AEC-Q200-Rev-E:2023;Table13 No.7 Humidity Bias | MIL-STD-202H:2015 Method 103 |
| AEC-Q006-Rev-A:2016;Table 3a | |
| 稳态温湿度寿命测试(无偏置)THS | |
| AEC-Q100-REV-J:2023;Table 2,Test group A3,TH | AEC-Q104-Rev:2017;Table 1,Test group A3,TH |
| JESD22-A101D.01:2021 | |






